การเรียนรู้ศิลปะการจัดงานบอลบอลอาร์เรย์
ตำแหน่งของบรรจุภัณฑ์เซมิคอนดักเตอร์ที่มีประสิทธิภาพและเชื่อถือได้ไม่สามารถพูดเกินจริงในโลกที่พัฒนาอย่างรวดเร็วของการผลิตอุปกรณ์อิเล็กทรอนิกส์เทคโนโลยี Ball Grid Array (BGA) กลายเป็นทางออกที่ดีในการตอบสนองความต้องการที่เพิ่มขึ้นของอุปกรณ์อิเล็กทรอนิกส์ที่ทันสมัยเพื่อประสิทธิภาพที่สูงขึ้นและย่อขนาดบทความนี้ขุดลงไปในรายละเอียดที่ซับซ้อนของเทคโนโลยี BGA สำรวจส่วนประกอบขั้นสุดท้ายกระบวนการและความท้าทายทางเทคนิคที่อยู่ในบรรจุภัณฑ์เซมิคอนดักเตอร์จากโครงสร้างพื้นฐานและข้อดีของ BGA ผ่านระบบพินแบบดั้งเดิมเช่นแพ็คแบบสี่เหลี่ยมจัตุรัสไปจนถึงกระบวนการที่ซับซ้อนของการบัดกรีการตรวจสอบและการทำงานซ้ำวาทกรรมนำเสนอการวิเคราะห์ที่ครอบคลุมแคตตาล็อก

รูปที่ 1: อาร์เรย์กริดบอล
พื้นฐานของอาร์เรย์กริดบอล
A Ball Grid Array (BGA) เป็นโซลูชันที่ทันสมัยในบรรจุภัณฑ์เซมิคอนดักเตอร์ออกแบบมาเพื่อเอาชนะความท้าทายของวิธีการที่มีอายุมากกว่าพินเช่นแพ็คแบบสี่เหลี่ยมจัตุรัสแทนที่จะใช้หมุดที่เปราะบาง BGA อาศัยลูกบอลประสานขนาดเล็กลูกบอลเหล่านี้อยู่ในตำแหน่งที่อยู่ด้านล่างของแพ็คเกจและมีจุดประสงค์เพื่อเชื่อมต่อกับแผ่นทองแดงที่ตรงกันบนแผงวงจรพิมพ์ (PCB)เมื่อความร้อนลูกบอลบัดกรีจะละลายและรักษาความปลอดภัย BGA ลงในกระดานสร้างการเชื่อมต่อที่แข็งแกร่งและเชื่อถือได้
รูปแบบ BGA ให้ข้อได้เปรียบในทางปฏิบัติหลายประการก่อนอื่นมันทำให้เค้าโครง PCB ง่ายขึ้นโดยลดความจำเป็นในการเชื่อมต่อระหว่างกันที่เต็มไปด้วยความหนาแน่นซึ่งระบบบรรจุภัณฑ์ก่อนหน้านี้จำเป็นเลย์เอาต์ที่มีประสิทธิภาพมากขึ้นนี้ทำให้ BGA ทนทานมากขึ้นและลดความเสี่ยงของความเสียหายในระหว่างการจัดการซึ่งแตกต่างจากพินที่ละเอียดอ่อนที่พบในแพ็คเกจเก่าที่สามารถโค้งงอหรือแตกได้ง่าย
นอกจากนี้ BGA ยังมีการจัดการความร้อนที่เหนือกว่าและประสิทธิภาพการใช้พลังงานไฟฟ้าการเชื่อมต่อสั้น ๆ โดยตรงระหว่าง BGA และ PCB ช่วยกระจายความร้อนได้อย่างมีประสิทธิภาพมากขึ้นซึ่งจะช่วยรักษาเสถียรภาพของวงจรภายใต้ความเครียดจากความร้อนเช่นกันเส้นทางไฟฟ้าที่สั้นกว่าภายใน BGA ลดการสูญเสียสัญญาณซึ่งเป็นสิ่งสำคัญโดยเฉพาะอย่างยิ่งสำหรับอุปกรณ์ที่ทำงานที่ความถี่สูงการรวมกันของความทนทานการกระจายความร้อนและประสิทธิภาพทางไฟฟ้าทำให้ BGA บรรจุภัณฑ์เป็นตัวเลือกที่ได้รับความนิยมมากขึ้นสำหรับอุปกรณ์อิเล็กทรอนิกส์ที่ทันสมัยเนื่องจากความซับซ้อนและความต้องการประสิทธิภาพของพวกเขาเพิ่มขึ้น
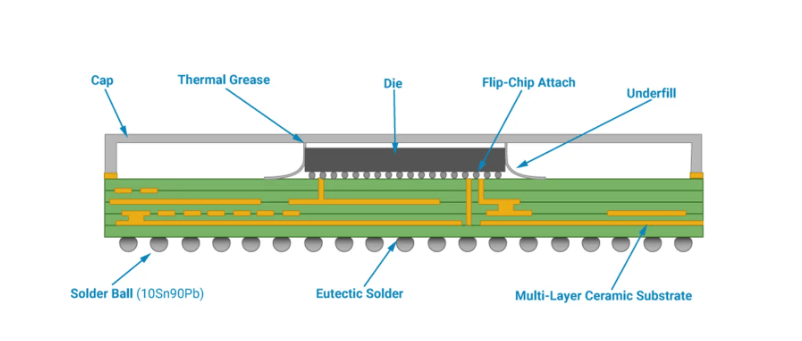
รูปที่ 2: กระบวนการบัดกรี BGA
การนำกระบวนการประสาน BGA
กระบวนการบัดกรีบอลกริดอาเรย์ (BGA) ถูกสอบสวนในขั้นต้นเนื่องจากความกังวลเกี่ยวกับความน่าเชื่อถือและความยากลำบากในการตรวจสอบการเชื่อมต่อที่ซ่อนอยู่ใต้ส่วนประกอบอย่างไรก็ตามเมื่อเวลาผ่านไปการบัดกรี BGA ได้พิสูจน์แล้วว่าเชื่อถือได้มากกว่าระบบเก่าเช่นแพ็คแบนสี่แพ็คขอบคุณการควบคุมที่แม่นยำในระหว่างกระบวนการบัดกรีความน่าเชื่อถือที่ได้รับการปรับปรุงนี้นำไปสู่การใช้อย่างแพร่หลายทั้งในการผลิตขนาดใหญ่และชุดประกอบ PCB ต้นแบบขนาดเล็ก
วิธีการบัดกรี Reflow นั้นโดดเด่นในการแนบ BGA เข้ากับแผงวงจรพิมพ์ (PCB)ในกระบวนการนี้แอสเซมบลีทั้งหมดจะถูกทำให้ร้อนถึงอุณหภูมิที่เฉพาะเจาะจงที่ประสานใต้ BGA จะละลายในสถานะกึ่งของเหลวขั้นตอนนี้ได้รับการควบคุมอย่างระมัดระวังเพื่อให้แน่ใจว่าบัดกรีรักษาโครงสร้างของมันและไม่ทำให้ลูกบัดกรียุบหรือผสานการควบคุมอุณหภูมิที่แม่นยำนั้นร้ายแรงเนื่องจากความผันผวนใด ๆ อาจส่งผลกระทบต่อคุณภาพของการเชื่อมต่อ
คุณลักษณะที่กว้างขวางของกระบวนการ reflow คือวิธีที่การประสานการหลอมเหลวความตึงผิวตามธรรมชาติของมันช่วยดึง BGA ให้เข้ากันได้อย่างสมบูรณ์แบบด้วยแผ่นรอง PCB แม้ว่าส่วนประกอบจะถูกปิดศูนย์เล็กน้อยเมื่อวางไว้ความสามารถในการแก้ไขตนเองนี้ช่วยให้มั่นใจได้ว่าการเชื่อมต่อแต่ละครั้งจะทำอย่างถูกต้องโดยไม่ต้องปรับเปลี่ยนด้วยตนเองเทคนิคขั้นสูงเหล่านี้ไม่เพียง แต่ทำให้การบัดกรี BGA มีความน่าเชื่อถือสูง แต่ยังมีประสิทธิภาพมากขึ้นช่วยให้ BGA เป็นตัวเลือกที่ต้องการในการผลิตแผงวงจรที่ทันสมัย
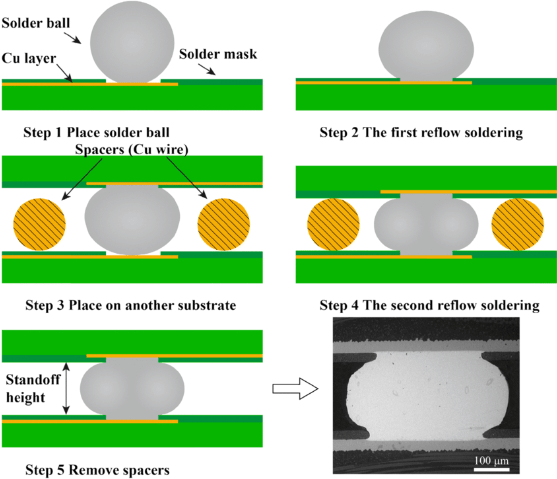
รูปที่ 3: การตรวจสอบข้อต่อ BGA ประสาน
จะตรวจสอบข้อต่อ BGA อย่างมีประสิทธิภาพได้อย่างไร?
การตรวจสอบข้อต่อประสาน BGA เป็นส่วนที่ยืนยันของกระบวนการประกอบซึ่งซับซ้อนโดยข้อเท็จจริงที่ว่าข้อต่อถูกซ่อนอยู่ใต้องค์ประกอบ BGAเนื่องจากการตรวจสอบด้วยภาพแบบดั้งเดิมไม่สามารถเข้าถึงการเชื่อมต่อที่ซ่อนอยู่เหล่านี้ได้ใช้เทคนิคการตรวจสอบรังสีเอกซ์และ X-ray อัตโนมัติ (AXI) เพื่อให้ได้มุมมองที่ชัดเจนและไม่รุกรานของข้อต่อบัดกรี
การตรวจสอบรังสีเอกซ์มีประโยชน์สำหรับการตรวจสอบข้อต่อประสานแต่ละครั้งอย่างละเอียดการถ่ายภาพช่วยให้ช่างเทคนิคเพื่อให้แน่ใจว่าลูกบอลประสานทั้งหมดละลายอย่างถูกต้องและสร้างพันธะที่แข็งแกร่งกับ PCBขั้นตอนนี้ใช้ในการระบุปัญหาเช่นข้อต่อเย็นซึ่งการประสานยังไม่ละลายหรือช่องว่างซึ่งเป็นกระเป๋าอากาศที่สามารถทำให้ข้อต่ออ่อนแอลงเมื่อเวลาผ่านไป
ผ่านเทคโนโลยีเอ็กซเรย์ผู้ตรวจสอบสามารถยืนยันได้ว่าปริมาณความร้อนที่เหมาะสมถูกนำไปใช้ในระหว่างกระบวนการ reflow และข้อต่อประสานตรงตามมาตรฐานที่แม่นยำการตรวจสอบระดับนี้ทำให้มั่นใจได้ว่าผลิตภัณฑ์ขั้นสุดท้ายมีความน่าเชื่อถือและสามารถทนต่อความเครียดในการดำเนินงานที่อาจเผชิญได้ช่วยรักษาคุณภาพการผลิตที่สูง
กลยุทธ์ที่มีประสิทธิภาพสำหรับการทำซ้ำ BGA ในอุปกรณ์อิเล็กทรอนิกส์
การทำงานใหม่ส่วนประกอบ BGA เป็นงานที่แม่นยำสูงซึ่งต้องมีการควบคุมอย่างระมัดระวังเกี่ยวกับกระบวนการทำความร้อนงานนี้มักจะทำที่สถานีทำงานซ้ำที่มีเครื่องมือที่ออกแบบมาโดยเฉพาะสำหรับงานความร้อนจากอินฟราเรดที่มีการแปลใช้เพื่อกำหนดเป้าหมาย BGA โดยไม่ต้องมีความร้อนสูงเกินไปในบริเวณใกล้เคียงเมื่อบัดกรีใต้ส่วนประกอบละลายเครื่องมือสูญญากาศจะยก BGA ออกจากกระดานอย่างระมัดระวังตลอดกระบวนการนี้ความร้อนจะต้องถูกควบคุมอย่างแม่นยำเพื่อหลีกเลี่ยงการสร้างส่วนประกอบที่อยู่ติดกันโดยเน้นถึงความจำเป็นในการทำอุปกรณ์ใหม่ขั้นสูง
การทำซ้ำ BGA ที่ประสบความสำเร็จขึ้นอยู่กับการรักษาการตั้งค่าอุณหภูมิที่แม่นยำและควบคุมสภาพแวดล้อมรอบ ๆ ส่วนประกอบสิ่งนี้จะช่วยป้องกันไม่ให้วงจรโดยรอบได้รับผลกระทบในระหว่างการกำจัดและการเปลี่ยน BGA ที่ผิดพลาดงานต้องการความเข้าใจอย่างลึกซึ้งเกี่ยวกับวิธีการทำงานของ BGAs และการจัดการที่มีทักษะเพื่อให้แน่ใจว่ากระบวนการดำเนินการอย่างถูกต้องเนื่องจากความซับซ้อนเหล่านี้ BGA rework เป็นการดำเนินการที่ละเอียดอ่อนซึ่งต้องใช้ทั้งอุปกรณ์ที่เหมาะสมและช่างเทคนิคที่มีประสบการณ์เพื่อรักษาความสมบูรณ์ของการชุมนุมทั้งหมด

รูปที่ 4: รูปแบบที่ดิน BGA PCB
กลยุทธ์การออกแบบสำหรับรูปแบบที่ดิน BGA PCB
การออกแบบรูปแบบที่ดิน PCB สำหรับ BGAs ต้องใส่ใจในรายละเอียดที่แม่นยำเพื่อให้แน่ใจว่าการเชื่อมต่อที่ราบรื่นและปลอดภัยในระหว่างการประกอบรูปแบบที่ดินจะต้องสอดคล้องอย่างสมบูรณ์กับกริดของ BGA เพื่อให้มั่นใจว่าลูกบอลประสานแต่ละลูกเรียงกันอย่างแม่นยำด้วยแผ่นที่สอดคล้องกันคุณสมบัติการออกแบบที่สำคัญเช่นการบรรเทาหน้ากากประสานและในบางกรณีปล่อยให้แผ่นรองที่ถูกค้นพบโดยหน้ากากถูกนำมาใช้เพื่อให้ประสานการไหลและสร้างพันธะที่แข็งแกร่งขึ้นการยึดมั่นอย่างเข้มงวดกับมาตรฐาน IPC นั้นมีประโยชน์ในการบรรลุระดับความแม่นยำที่ต้องการสำหรับการบัดกรี BGA ที่ประสบความสำเร็จ
ทุกแง่มุมของรูปแบบที่ดินจะต้องมีการวางแผนอย่างรอบคอบเพื่อตอบสนองความต้องการเฉพาะขององค์ประกอบ BGAซึ่งรวมถึงการปรับขนาดของแผ่นรองและจัดการความคลาดเคลื่อนตำแหน่งอย่างระมัดระวังเพื่อให้แน่ใจว่าการเชื่อมต่อแต่ละครั้งนั้นไร้ที่ติการวางแผนอย่างรอบคอบในขั้นตอนการออกแบบทำให้มั่นใจได้ว่ากระบวนการบัดกรีนั้นมีประสิทธิภาพและเชื่อถือได้ช่วยให้ BGA ยึดติดอย่างปลอดภัยและทำงานได้อย่างเหมาะสมภายในชุดประกอบ PCB
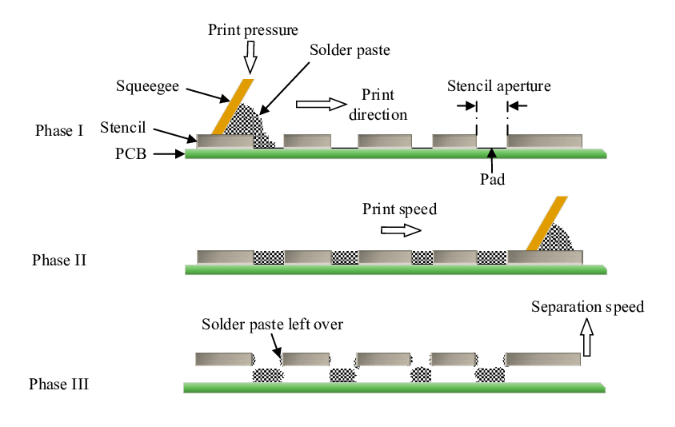
รูปที่ 5: การพิมพ์บัดกรี BGA
บรรลุความแม่นยำในการพิมพ์บัดกรี BGA
การใช้การวางบัดกรีสำหรับการประกอบ BGA ต้องใช้เทคนิคการเย็บเล่มที่แม่นยำเพื่อให้แน่ใจว่ามีการวางปริมาณที่แน่นอนที่แน่นอนไว้ภายใต้ลูกบอล BGA แต่ละลูกกระบวนการนี้ใช้ลายฉลุเลเซอร์ตัดซึ่งสอดคล้องกับรูปแบบที่ดิน PCB อย่างสมบูรณ์แบบเพื่อปรับปรุงความแม่นยำเพิ่มเติมและลดข้อบกพร่องเช่นบอลบัดกรี stencils เหล่านี้มักจะได้รับการรักษาด้วย nanocoatingsหัวพิมพ์ขนาดเล็กจากนั้นควบคุมปริมาณการวางอย่างระมัดระวังที่ใช้กับแต่ละแผ่นในขณะที่ระบบตรวจสอบด้วยแสงตรวจสอบว่าวางวางด้วยความแม่นยำสูง
ประเภทของการวางบัดกรีที่ใช้ - ประเภท 3 หรือประเภท 4 - ขึ้นอยู่กับความหนืดที่ต้องการสำหรับการประกอบเฉพาะทางเลือกของการวางส่งผลโดยตรงต่อความดีของข้อต่อประสานในระหว่างกระบวนการ reflowเนื่องจากขั้นตอนนี้วางรากฐานสำหรับความแข็งแกร่งและความน่าเชื่อถือของการเชื่อมต่อขั้นสุดท้ายกระบวนการพิมพ์บัดกรีเป็นส่วนหนึ่งที่อันตรายของการประกอบ BGA ซึ่งต้องได้รับการใส่ใจอย่างระมัดระวังในรายละเอียดเพื่อให้แน่ใจว่าผลลัพธ์ที่มีคุณภาพสูง
ความซับซ้อนของการบัดกรี BGA
การบัดกรี BGAs นำเสนอปัญหาที่ไม่เหมือนใครเนื่องจากข้อต่อประสานถูกซ่อนอยู่ใต้ส่วนประกอบทำให้การตรวจสอบด้วยภาพโดยตรงเป็นไปไม่ได้ในการแก้ไขปัญหานี้เครื่องมือพิเศษเช่นเครื่องเอ็กซ์เรย์ใช้เพื่อตรวจสอบการเชื่อมต่อในขณะที่สถานีทำงานซ้ำอินฟราเรดอนุญาตให้มีการปรับแต่งส่วนประกอบที่แม่นยำเมื่อจำเป็นการจัดการกระบวนการบัดกรียังต้องมีการควบคุมความร้อนอย่างระมัดระวังเพื่อหลีกเลี่ยงการเน้นข้อต่อประสานซึ่งอาจนำไปสู่รอยแตกในทำนองเดียวกันลูกบอลประสานทั้งหมดจะต้องรักษาความสูงเท่ากัน (coplanarity) เพื่อให้แน่ใจว่าประสิทธิภาพที่สอดคล้องกันและความน่าเชื่อถือในระยะยาว
ปัจจัยด้านสิ่งแวดล้อมเช่นความชราและความไวต่อความชื้นจะทำให้กระบวนการมีความซับซ้อนยิ่งขึ้นปัญหาเหล่านี้จำเป็นต้องได้รับการควบคุมอย่างเข้มงวดเพื่อป้องกันการเสื่อมสภาพของข้อต่อประสานเมื่อเวลาผ่านไปการสำรวจความท้าทายเหล่านี้ประสบความสำเร็จนั้นต้องการความเข้าใจอย่างถ่องแท้เกี่ยวกับเทคนิคการบัดกรี BGA และการใช้อุปกรณ์ขั้นสูง
อาร์เรย์กริดบอลประเภทต่างๆ
เทคโนโลยี Ball Grid Array (BGA) เป็นวิธีการติดตั้งวงจรรวม (ICS) ลงบนแผงวงจรพิมพ์ (PCBs) ที่ปรับปรุงการเชื่อมต่อไฟฟ้าและการกระจายความร้อนมันใช้อาร์เรย์ของลูกบอลประสานใต้ส่วนประกอบเพื่อสร้างการเชื่อมต่อที่ปลอดภัย

รูปที่ 6: อาร์เรย์กริดลูกบอลพลาสติก (PBGA)
BGA พลาสติกมีการใช้กันอย่างแพร่หลายเนื่องจากมีราคาไม่แพงและให้ประสิทธิภาพที่เชื่อถือได้สำหรับการใช้งานมาตรฐานส่วนใหญ่พวกเขาประกอบด้วยสารตั้งต้นพลาสติกที่มีลูกประสานติดอยู่ด้านล่างสิ่งเหล่านี้มักพบในอุปกรณ์อิเล็กทรอนิกส์ผู้บริโภคระบบยานยนต์และอุปกรณ์อื่น ๆ ที่ไม่ทำงานภายใต้เงื่อนไขที่รุนแรงการออกแบบที่เรียบง่ายของพวกเขามีการเชื่อมต่อไฟฟ้าที่ดีและการจัดการความร้อนในระดับปานกลางซึ่งเพียงพอสำหรับการใช้งานในชีวิตประจำวัน
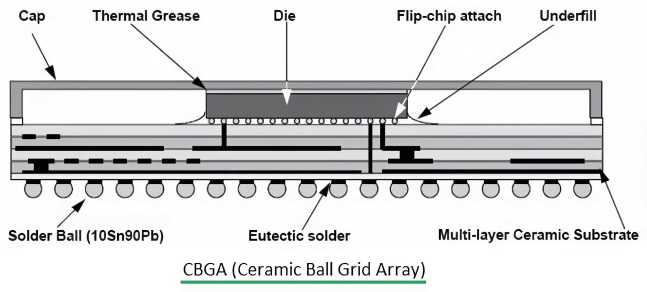
รูปที่ 7: อาร์เรย์กริดลูกเซรามิก (CBGA)
เซรามิก BGAs ใช้สารตั้งต้นเซรามิกทำให้มีความทนทานต่อความร้อนและการรบกวนทางไฟฟ้ามากกว่า BGAs พลาสติกความทนทานนี้ทำให้พวกเขาเหมาะสำหรับการเรียกร้องสภาพแวดล้อมเช่นการสื่อสารโทรคมนาคมการบินและอวกาศและเซิร์ฟเวอร์ระดับสูงเซรามิกให้ฉนวนที่ยอดเยี่ยมและสามารถจัดการทั้งอุณหภูมิสูงและความเครียดเชิงกลทำให้มั่นใจได้ถึงความน่าเชื่อถือในระยะยาวของอุปกรณ์
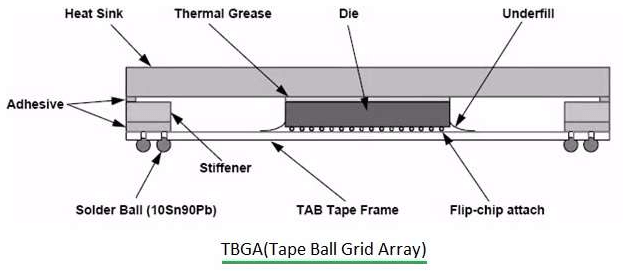
รูปที่ 8: เทป BGAs (TBGA)
เทป BGAs ได้รับการออกแบบด้วยสารตั้งต้นที่ยืดหยุ่นซึ่งสามารถสอดคล้องกับพื้นผิวของ PCB ปรับปรุงทั้งการเชื่อมต่อเชิงกลและการกระจายความร้อนBGA เหล่านี้เหมาะสำหรับอุปกรณ์อิเล็กทรอนิกส์แบบพกพาและอุปกรณ์ที่มีความหนาแน่นสูงซึ่งมีพื้นที่ จำกัดลักษณะที่ยืดหยุ่นของสารตั้งต้นช่วยให้การจัดการความร้อนที่ดีขึ้นในพื้นที่ขนาดกะทัดรัดทำให้พวกเขาเป็นตัวเลือกที่ต้องการสำหรับสมาร์ทโฟนและอุปกรณ์พกพาอื่น ๆ
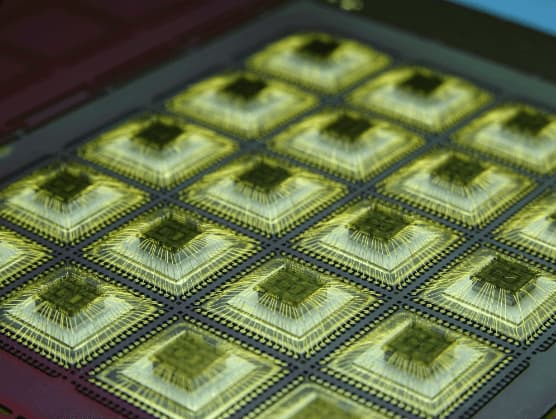
รูปที่ 9: bgas ตายซ้อนกัน
BGA แบบตายแบบซ้อนถูกใช้ในอุปกรณ์ที่จำเป็นต้องบรรจุกำลังการประมวลผลจำนวนมากในพื้นที่ขนาดเล็กประเภทนี้สแต็กวงจรรวมหลายวงในแนวตั้งภายในแพ็คเกจเดียวทำให้สามารถใช้งานได้มากขึ้นโดยไม่ต้องเพิ่มขนาดของอุปกรณ์BGA แบบตายแบบเรียงซ้อนมักพบได้ในสมาร์ทโฟนแท็บเล็ตและอุปกรณ์อิเล็กทรอนิกส์ขนาดกะทัดรัดอื่น ๆ ที่ต้องการประสิทธิภาพสูงในรูปแบบขนาดเล็ก
บทสรุป
การสำรวจเทคโนโลยี Ball Grid Array (BGA) ตอกย้ำบทบาทสำคัญในภูมิทัศน์การผลิตอิเล็กทรอนิกส์ที่ทันสมัยตามรายละเอียดในบทความนี้บรรจุภัณฑ์ BGA ไม่เพียง แต่ระบุถึงข้อ จำกัด ทางกายภาพของวิธีการบรรจุภัณฑ์ที่เก่ากว่า แต่ยังช่วยเพิ่มประสิทธิภาพผ่านการจัดการความร้อนและประสิทธิภาพทางไฟฟ้าที่ดีขึ้นกระบวนการทางเทคนิคที่เกี่ยวข้องกับการบัดกรี BGA การตรวจสอบและการทำใหม่สะท้อนให้เห็นถึงความมุ่งมั่นต่อความแม่นยำและความน่าเชื่อถือทำให้มั่นใจได้ว่าอุปกรณ์อิเล็กทรอนิกส์เป็นไปตามข้อกำหนดที่เข้มงวดของมาตรฐานทางเทคโนโลยีในปัจจุบัน
นอกจากนี้ BGAs ประเภทต่าง ๆ ตั้งแต่ BGA พลาสติกไปจนถึง BGA ที่มีการนำความร้อนสูงเป็นต้นมาให้ความสำคัญกับแอพพลิเคชั่นในวงกว้างเพื่อพิสูจน์ความสามารถรอบตัวและการปรับตัวของเทคโนโลยี BGAในที่สุดเมื่ออุปกรณ์อิเล็กทรอนิกส์ยังคงพัฒนาในความซับซ้อนและการใช้งานเทคโนโลยี BGA จะยังคงจำเป็นต่อการขับเคลื่อนนวัตกรรมและรักษามาตรฐานคุณภาพสูงในบรรจุภัณฑ์เซมิคอนดักเตอร์
คำถามที่พบบ่อย [คำถามที่พบบ่อย]
1. จะประสานแพ็คเกจ BGA ได้อย่างไร?
การตระเตรียม: เริ่มต้นด้วยการทำความสะอาดแพ็คเกจ BGA และ PCB (แผงวงจรพิมพ์) เพื่อลบสารปนเปื้อนหรือสารตกค้างใด ๆ
การจัดตำแหน่ง: จัดเรียงแพ็คเกจ BGA อย่างระมัดระวังบน PCB เพื่อให้แน่ใจว่าแผ่นทั้งหมดบนชิปจัดตำแหน่งกับแผ่นรองที่เกี่ยวข้องบนกระดาน
บัดกรี: ใช้กระบวนการบัดกรี reflowวาง PCB ด้วย BGA ลงในเตาอบรีฟว์การประสานที่ใช้กับแผ่นรองจะละลายและการเชื่อมต่อแบบฟอร์มในระหว่างรอบการทำความร้อน
ความเย็น: อนุญาตให้ PCB เย็นลงอย่างช้าๆหลังจากกระบวนการรีดว์เพื่อหลีกเลี่ยงความเครียดจากความร้อน
2. BGA ในการบัดกรีคืออะไร?
BGA ย่อมาจากอาร์เรย์กริดบอลมันเป็นบรรจุภัณฑ์แบบติดตั้งพื้นผิวที่ใช้สำหรับวงจรรวมแพ็คเกจ BGA ใช้ลูกบอลขนาดเล็กของบัดกรีจับจ้องอยู่ที่ด้านล่างของแพ็คเกจเพื่อสร้างการเชื่อมต่อไฟฟ้ากับ PCB แทนโอกาสในการขายแบบดั้งเดิม
3. วิธีการบัดกรีบอล?
ตำแหน่งลูก: ใช้บัดกรีวางกับแผ่น PCB ที่จะวาง BGAวางตำแหน่ง BGA เพื่อให้ลูกบอลประสานแต่ละลูกจัดเรียงกับแผ่นที่สอดคล้องกันบน PCB
reflow การบัดกรี: ความร้อนการประกอบในเตาอบรีดว์การบัดกรีวางจะละลายผูกบัดลูกเข้ากับแผ่นและสร้างการเชื่อมต่อไฟฟ้าและเครื่องจักรกล
การตรวจสอบ: หลังจากการบัดกรีตรวจสอบการเชื่อมต่อสำหรับสะพานหรือข้อต่อที่ไม่ดีโดยทั่วไปใช้การตรวจสอบรังสีเอกซ์เพื่อดูใต้ BGA
4. วิธีตรวจสอบการบัดกรี BGA?
การตรวจสอบด้วยภาพ: เริ่มแรกให้ตรวจสอบการจัดแนวหรือข้อบกพร่องที่มองเห็นได้รอบ ๆ แพ็คเกจ BGA
การตรวจสอบเอ็กซ์เรย์: เนื่องจากการบัดกรี BGA ไม่สามารถตรวจสอบได้อย่างสมบูรณ์ด้วยสายตาเนื่องจากธรรมชาติที่ซ่อนอยู่ของการเชื่อมต่อใช้การตรวจสอบรังสีเอกซ์เพื่อตรวจสอบข้อต่อประสานใต้ BGA
การทดสอบการทำงาน: ในที่สุดทำการทดสอบไฟฟ้าเพื่อให้แน่ใจว่าการเชื่อมต่อทั้งหมดทำงานได้อย่างถูกต้อง
5. บัดกรี BGA ควรอุณหภูมิเท่าใด?
อุณหภูมิทั่วไป: อุณหภูมิที่แม่นยำสำหรับการบัดกรี BGA ขึ้นอยู่กับการวางบัดกรีที่ใช้โดยทั่วไปแล้วการวางบัดกรีแบบตะกั่วต้องใช้อุณหภูมิประมาณ 217 ° C ถึง 245 ° Cตรวจสอบข้อกำหนดของผู้ผลิตบัดกรีสำหรับอุณหภูมิที่แน่นอน
โปรไฟล์ Reflow: ทำตามโปรไฟล์ความร้อนที่เฉพาะเจาะจงที่ค่อยๆร้อนการประกอบไปที่อุณหภูมิรีดรีว์ที่ต้องการถือไว้นานพอที่จะทำให้แน่ใจว่าการหลอมละลายที่เหมาะสมจากนั้นทำให้เย็นลงเรื่อย ๆ เพื่อหลีกเลี่ยงความเครียดจากความร้อน
เกี่ยวกับเรา
ALLELCO LIMITED
อ่านเพิ่มเติม
สอบถามรายละเอียดเพิ่มเติมอย่างรวดเร็ว
กรุณาส่งคำถามเราจะตอบกลับทันที
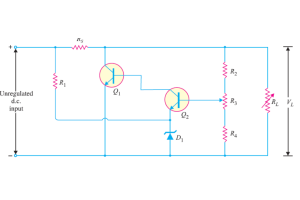
การวิเคราะห์เชิงลึกของหน่วยงานกำกับดูแลแรงดันไฟฟ้าแบบปัดในอิเล็กทรอนิกส์สมัยใหม่
บน 09/09/2024

ตัวต้านทาน 220 โอห์ม
บน 09/09/2024
โพสต์ยอดนิยม
-

GND ในวงจรคืออะไร?
บน 01/01/1970 3039
-

คู่มือเชื่อมต่อ RJ-45: รหัสสีตัวเชื่อมต่อ RJ-45, แผนการเดินสาย, แอปพลิเคชัน R-J45, RJ-45 Datasheets
บน 01/01/1970 2608
-

ประเภทตัวเชื่อมต่อไฟเบอร์: SC vs LC และ LC กับ MTP
บน 01/01/1970 2162
-

การทำความเข้าใจแรงดันไฟฟ้าของแหล่งจ่ายไฟในอิเล็กทรอนิกส์ VCC, VDD, VEE, VSS และ GND
บน 13/11/0400 2073
-

การเปรียบเทียบระหว่าง DB9 และ RS232
บน 01/01/1970 1790
-

แบตเตอรี่ LR44 คืออะไร?
กระแสไฟฟ้าที่ใช้กำลังแพร่หลายแทรกซึมทุกแง่มุมของชีวิตประจำวันของเราตั้งแต่อุปกรณ์เล็กน้อยไปจนถึงอุปกรณ์การแพทย์ที่คุกคามชีวิตมันมีบทบาทเงียบอย่างไรก็ตามการเข้าใจพลังงานนี้อย่างแท้จริงโดยเฉพาะอย่างยิ่ง...บน 01/01/1970 1754
-

การทำความเข้าใจพื้นฐาน: การต่อต้านการเหนี่ยวนำและความสามารถพิเศษ
ในการเต้นรำที่ซับซ้อนของวิศวกรรมไฟฟ้าทั้งสามองค์ประกอบพื้นฐานต้องใช้เวทีกลาง: การเหนี่ยวนำความต้านทานและความจุแต่ละหมีมีลักษณะเฉพาะที่กำหนดจังหวะแบบไดนามิกของวงจรอิเล็กทรอนิกส์ที่นี่เราเริ่มต้นการเดินท...บน 01/01/1970 1706
-

คู่มือการใช้แบตเตอรี่ CR2430: ข้อมูลจำเพาะแอปพลิเคชันและการเปรียบเทียบกับแบตเตอรี่ CR2032
แบตเตอรี่ CR2430 คืออะไร?ประโยชน์ของแบตเตอรี่ CR2430บรรทัดฐานแอปพลิเคชันแบตเตอรี่ CR2430CR2430 เทียบเท่าCR2430 เทียบกับ CR2032ขนาดแบตเตอรี่ CR2430สิ่งที่จะมองหาเมื่อซื้อ CR2430 และเทียบเท่าแผ่นข้อมูล PDFคำถามที่พบบ่อย แบตเตอรี่เป็นห...บน 01/01/1970 1640
-

RF คืออะไรและทำไมเราถึงใช้มัน?
เทคโนโลยีความถี่วิทยุ (RF) เป็นส่วนสำคัญของการสื่อสารไร้สายที่ทันสมัยทำให้สามารถส่งข้อมูลในระยะทางไกลได้โดยไม่ต้องเชื่อมต่อทางกายภาพบทความนี้นำเสนอพื้นฐานของ RF อธิบายว่ารังสีแม่เหล็กไฟฟ้า (EMR) ทำให้การสื่อส...บน 01/01/1970 1621
-

คู่มือที่ครอบคลุมถึง HFE ในทรานซิสเตอร์
ทรานซิสเตอร์เป็นส่วนประกอบสำคัญในอุปกรณ์อิเล็กทรอนิกส์ที่ทันสมัยช่วยให้การขยายสัญญาณและการควบคุมบทความนี้นำเสนอความรู้เกี่ยวกับ HFE รวมถึงวิธีการเลือกค่า HFE ของทรานซิสเตอร์วิธีการค้นหา HFE และการได้รับทรานซ...บน 13/11/5600 1564



















































